
露光機

全自動露光機




露出光源:
● 露出源:水銀ランプ350W、500W、1000W、またはUV LED。
● 露出光源口径: 4",6",8",10",12"円、または4",6"、8"方
● 波長:水銀ランプNUV(365nm、405nm、435nm)、UV LED(365nm、
405nm)
● 光源平行半角:1.5~2.5度(出光口径による)
● 均一度: +-3~5% (選択+-2%)
● 高圧水銀電球、またはUV LEDランプセット及び電源供給器付き(回
授型を選択)
自動照準台:
● 光カバー真空吸盤:上吸式または下吸式4", 5", 6", 9"
● ウェーハ真空吸盤: 2", 4", 6",7" ,9”
● 光カバーウェーハ水平補正機能付き
● 露出モードは接触式と近接式を選択できます。
● X、Y、T軸モーター調整10mm。解像度1um
● Z軸モーター調整5mm、解像度1um
● ライトカバーは前後に転送され、取り出しと置きに便利です。
● 自動照準動作は自動照準ソフトウェアの計算結果によって
PLCによって制御され、調整されます。
映像システム:
固定倍率レンズを採用し、それぞれ事前対位、入片粗対位、精密対の三つの位置に配置されます。
CCD映像システムは映像をPCにキャプチャし、映像の自動対位を行う。
映像照明にはLED同軸光または環状光があります
予対転出:
入片は小腕から予対台に送られて大まかな位置を決め、露出後小腕から転接台に送られ
転送小腕と回転盤:
5本の小さな腕がウェーハ転送を行い、三つの吸盤回転台と照準台を組み合わせることで、迅速な対位と入出片ができます
入力と出力カードボックス:
入力カードボックス台は腕から基板を予対台に渡す。露出後の基板は、アダプタから出力カードボックスの晶舟に伝達される。未完成は基本的に退席に移る。カードボックス台はマルチカードボックスデザインができる.
オペレーティングシステム:
PLC及びヒューマンマシンインターフェース制御システムと産業用コンピュータの自動アライメントソフトウェア、基板の出力とアライメント露出プロセスの自動操作を行う
架台:
四つの耐震エアクッション、調整脚、移動ホイール、アルミ押出型フレームとアルミ板及び黄色のPVC帯電防止板で覆う機械台を備え、いくつかの操作と修理ドアと窓と窓を開く
性能:
生産量は対位精度と露出時間によって異なり、高生産機種は最速で毎分5枚以上に達することができる、
採接触露出グラフィック解析は最適で1~2umに達する採近接式露出
はウェーハと光カバーの間隔によって約5~2umに設定されます

半自動露光機
半自動光マスク照準露光機は操作が簡単で、性能が信頼でき、量産ラインでの使用に適しています



露出光源:
● 露光源:水銀ランプ350W、500W、1000W、またはUV LEDランプ
● 露出光源サイズ:4",6",8",10",12"円、または4",6",8"方
● 波長:水銀ランプNUV(365nm、405nm、435nm)、UV LED(365nm、
405nm)
● 光源平行半角:1.5~2.5度、(出光口径による)
● 均一度: +-3~5% (選択+-2%)
● 高圧水銀電球、またはUV LEDランプセット及び電源供給器付き (回授型を選択)
露出照準台:
● 光カバー真空吸盤:上吸式または下吸式4", 5", 6", 7", 9"
● ウェーハ真空Chuck: 2", 4", 6",8"円形または正方形
● 光カバーウェーハ平行補正機能付き
● 露出モードには真空接触、ソフト接触と近接式があり、真空吸着
力の大きさを調整できます
● X、Y、T軸手調整ストローク10mm。解像度を調整する1um
● Z軸手調整ストローク3mm、千分計解像度1um、(オプション電動調整)
● ライトカバー吸盤が自動的に開き、基板を取り出す
映像システム:
可変倍率レンズを採用し、照準操作が便利で、標準倍率は50X-300X、様々な倍率、CCD映像システム、LCDスクリーン表示をオプションで装備できます。
LED同軸光打光、(環状光をオプション)
観測された二点の間隔は4cm-15cm、(より小さい間隔に転換鏡をオプションで装備する)レンズスキャン台をオプションで装備し、レンズを素早く移動できます。
背面照準映像システムを選択可能
架台:
四つの防振エアクッション、調整脚、移動ホイール、フレーム及び盤面、大型アルミ板機座、左右移動リニアスライドレール、CDAの調整、電源出力などを備えている。
オペレーティングシステム:
PLC半自動操作システム、(マンマシンインターフェースをオプション)。
手動と半自動モードを切り替えることができます
操作の流れ:基板を置き、(ボタン)上光カバーをオフにし、レンズを移動して照準動作を行い、(ボタン)露出モードを選択し、(ボタン)レンズを移動して光源を露出に移し、光源を移動し、光カバー吸盤を開き、基板を取ります。
露出シャッター制御:タイマー制御0.1
性能:
生産量は対位精度及び露出時間及びオペレーターの熟練度によって異なり、最速で毎分三枚を露出できる
真空接触露光図解析は1um(正光抵抗厚さ1um)まで最適で、近接式露光は約2~5umで最適です。

両面アライメント露光機
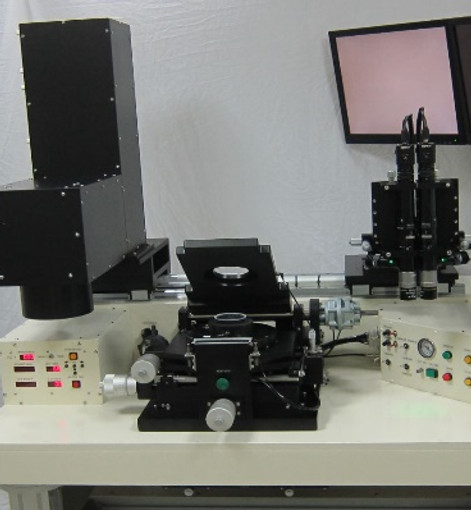


露出燈源:
● 露出源:水銀ランプ350W、500W、1000W、またはUV LED。
● 露出光源口径: 4",6",8",10",12"円、または4",6"、8"方
● 波長:水銀ランプNUV(350nm~450nm), UV LED(365nm, 405nm)
● 光源平行半角:1.5~2.5度(出光口径による)
● 均一度: +-3%
● 高圧水銀電球、またはUV LEDランプセット及び電き(回授型を選択)
両面照準台:
● ライトカバー真空吸盤: 4”, 5”, 7”, 9”
● ウェーハ真空吸盤: 2”,3”, 4”, 6” 8”
● ウエハース真空吸盤に穴を開けて、バックアリング用。
● ライトカバーウェーハ平行面補正機能付き
● 露出モードには真空接触式、接触式と近接式があり、
● X、Y軸調整ストローク:12mm.解像度1umを調整する。
● 回転軸調整角度:5度、調整解析0.001度、
● Z軸調整ストローク:3mm調整解像度1um.千分計表示。
● 置置チップはウェーハプッシュプルディスク式またはライト
カバー上開式を選択できます。
上照準映像システム:
可変倍率レンズを採用し、多様な倍率の組み合わせ
ダブルCCD映像システム、LCDスクリーン
LED同軸打光または環状打光
レンズの前後左右上下微調整約20mm、
クイックスキャンテーブルをオプションで装備できます。
映像の解像度は最高で1umに達する。
バックアイメント映像システム:
固定倍率レンズを採れる
デュアルCCD映像システム、映像LCDスクリーンを切り替えて使用する
LED同軸打光
バック照準画像処理ソフト
レンズの前後左右上下微調整約10mm、
映像の解像度は最高で1umに達する。
オペレーティングシステム:
全手動ボタン操作システム、または半自動PLC制御システムを選択可能
機構移動採気シリンダー駆動、光源と映像システムの移動は採左右個別移動(光カバー上開式)または前後交互移動(ウェーハプッシュプルディスク式)。
露出制御:計時制御、オプションでエネルギー制御
防振架台:
大きなアルミ板の台座には4つの耐震エアクッション、フレーム調整脚、移動ホイール、
CDAの入力調整、真空入力、電源出力入力。

両面露光機
半自動両面露光機、操作が簡単で、性能が信頼でき、生産能力が2倍になり、量産ラインでの使用に適しています



上下露出光源:
● 露出源:水銀ランプ350W、500W、1000W、またはUV LED
● ランプ露出光源サイズ:4",6",8",10",12"円、または4",6",8"方
● 波長:水銀ランプNUV(365nm、405nm、435nm)、UV LED(365nm、
405nm)
● 光源平行半角:1.5~2.5度(出光口径による)
● 均一度: +-3~5% (選択+-2%)
● 高圧水銀電球、またはUV LEDランプセット及び電源供給器付き (回授型を選択)
両面露出照準台:
● 上及び下光マスク真空吸盤: 4", 5", 6", 7",9"
●基板固定クリップ: 2", 4", 6",8"
● 下光カバーは上光カバーに対して平行面を手動で調整できます
● 露出モードは接触式
● ライトカバーとライトカバーの合わせ:X、Y、Y軸調整10mm。
細い歯のネジ調整
● 上光カバーは基板に合わせる:XYΘ調整10mm、分厘カードヘッド
調整
● 上光カバーを開けて基板を取り出し、基板の対角は固定クリップ
で二つの光カバーの間に固定する
映像システム:
可変倍率レンズを採用し、照準操作が便利で、標準倍率は50X-300X
CCD映像システム、2つのLCDスクリーン
照明にはLED同軸光、バックライトまたは環状光があります
レンズスキャン台を追加して、素早くレンズを動かすことができます。
ライトカバー監視レンズを追加して、上下のライトカバーの変位を監視することができます。
架台:
四つの耐震エアクッション、調整脚、移動ホイール、ステンレススタンド及び盤面、アルミニウム合金卓上及びリブプレート、CDAの調整、真空表示、電源出力などを備えている。
オペレーティングシステム:
PLC半自動操作システム、
手動と自動モードを切り替えることができます
操作の流れ:基板を設置し、(ボタン)上光カバーを閉じ、レンズを移動して合わせ動作を行い、(ボタン)上光カバーを下圧し、レンズを移動して光源を移動して露出する
(計時)、光源を移動して取り、上光カバーを開けて、基板を取り出す。
露出タイマー時間設定:0.1-999秒
性能:
生産量は対位精度、露出時間及びオペレーターの熟練度によって異なり、最速で毎分三枚を露出できる

全自動マスク露光機
全手動光マスク照準露光機は実験室研究使用、または量産前工程開発使用に適しています




露出光源:
● 露光源:水銀ランプ350W、500W、1000W、またはUV LEDランプ
● 露出光源サイズ:4",6",8",10",12",円または正方形、
● 波長:水銀ランプNUV(350nm~450nm), UV LED(365nm, 405nm,435nm)
● 光源平行半角:1.5~2.5度(出光口径による)
● 均一度: +-3~5%
● 高圧水銀電球、またはUV LEDランプセット及び電源装置付き
露出台:
● 光カバー真空吸盤:上吸式または下吸式4", 5", 6", 7", 9"
● ウェーハ真空吸盤: 2", 4", 5", 6",8" , 円形または正方形,
● 光カバーウェーハ水平補正機能付き
● 露出モードには真空接触式と近接式があり、真空吸着力の大きさ
を調整できます
● X、Y軸調整10mm。調整感度最適1um
● Z軸は3mm調整可能、千分計解像度1um
● 上光カバーを手で開けて基板を取り出す
映像システム:
可変倍率レンズ、画面倍率約80X-500X
映像解像度は最高1.5um
ビデオカメラ、LCDスクリーン
打光にはLED同軸光または環状光があります
観測の二点間隔は4cm-15cm、(より小さい間隔に転換鏡を選ぶ)
レンズスキャン台を購入してレンズを素早く移動させる、
背面を合わせた機種を選ぶ
架台:
大型アルミ板機座、ステンレススタンド、四つの耐震エアクッション、調整脚、移動ホイール、CDA入力調整、真空入力、電源出力入力など
オペレーティングシステム:
全手動操作システム、すべての動作は手動で操作する必要があります、
操作の流れ:
基板を置き、手動でライトカバー吸盤を閉じ、レンズを移動して照準動作を行い、chuckを露出位置に移動し、レンズを移動し、光源を露出(計時)に移動し、光源を移動し、ライトカバー吸盤を開き、基板を取り出します。
露出タイマー時間設定:0.1-999秒
エネルギー露出を購入する
性能:
真空接触露出グラフィック解析は1um以内(正光抵抗厚さ1um)まで最適です。
採近接式露出はウェーハとライトカバーの間隔によって最適に5~2umに設定します。

卓上型アライメント露光装置



露出光源:
● 露出源:水銀ランプ350W or 500W、またはUV LEDランプ
● 露出光源サイズ: :4", 5" ,6" or 8"
● 波長範囲: NUV, I-line 強度: 約10~25mW/cm2@6”
● 均一度: +-5%以内, 平行角: ±2.5°
● 電源装置一台
● 露出制御タイマー:0.1~999.9秒 一台
● 高圧水銀ランプ一つ、またはUV LEDランプセット一つ付き
露出照準台:
● マスク真空吸盤: 4”,5"または6”下吸式
● ウェーハ真空吸盤:破片,2”,3" ,4" または5”
● 光カバーとウェーハ平行面補正真空球座
● ウェーハ真空吸盤は前後左右12mm調整でき、感度は2um調整
できます
● 回転調整5度、調整感度0.001度
● Z軸は約3mmで調整でき、感度は1umです。
● Z軸はマイクロメーターを備えており、マスクとウェーハの
間隔を表示でき、解像度は1umです。
● Z軸は照準と露出の2種類のギャップを設定できます
● 接触真空吸着力の大きさを調整できる
● 露出モードにはVacuum contact、Soft contact、Proximity
があります
● 手動でチップを配置し、チップの位置を調整し、ウェーハ
タイムカバーの吸盤を手で開けます。
映像システム:
可変倍率レンズ、ビデオカメラ、LCDスクリーン、LED光源各一組、また二組
映像システム総映像倍率50X-300X。
映像解像度は最高1.5um
レンズの位置調整、前後左右上下約20mm微調整可能、
シングルレンズはクイックスキャン台をオプションで装備し、レンズを素早く移動でき、前後左右に約10cm移動できます。
架台:
卓上型大底板機座、調整脚付き
オペレーティングシステム:
手動ボタン操作システムを採り、手動コントロールパネルで操作する。
操作項目はライトカバーとウェーハの交換、ライトカバーとウェーハの隙間の切り替えを含む。
マスクとウェーハの平行面補正、真空接触の切り替えと真空値の調整。
Z軸計量器のゼロ化、レンズと露出源は左右に交互に照準台の上に移動し、安全インターロック機能があります。
性能:
採真空接触露光グラフィック解析は1umまで最適、近接露光カバーとウェーハの隙間は5~2umまで最適

簡易手動露光装置



露出光源:
●露光源:水銀ランプ350W、500W、1000W、またはUV LEDランプ
● 露出光源サイズ:4",6",8",10",12",円または正方形、
● 波長:水銀ランプNUV(350nm~450nm), UV LED(365nm, 405nm,435nm)
● 光源平行半角:1.5~2.5度(出光口径による)
● 均一度: +-3~5%
● 高圧水銀電球、またはUV LEDランプセット及び電源装置付き
露出台:
● マスク真空吸盤: 4”,5”,6”,7”,9” (オプション)
● ウェーハまたは基板真空吸盤: 2”,4”,5”,6” ,8”,12”
(オプション)
● 光カバーとウェーハまたは基板の平行面補正機能を備えている
● Z軸は約3mmを手動で調整でき、解像度を1um調整できます。
● Z軸はマイクロメーターを備えており、ライトカバーとウェーハの
間隔を表示できます。
● 露出モードにはVacuum contact、Soft contact、Proximityがあり
ます
● チップまたは基板を手動で配置し、チップの位置を調整し、
ウェーハタイムカバーの吸盤を上向きに開く
映像システム:
なし
架台:
大きなアルミ板台座、ステンレスフレーム、四つの耐震エアクッション、調整脚、移動ホイール、CDA入力調整、真空入力、電源出力入力など。
オペレーティングシステム:
手動ボタン操作システムを採り、手動コントロールパネルで操作する
操作項目には、ライトカバーとウェーハの交換、ライトカバーとウェーハの隙間の切り替え、ライトカバーとウェーハの平行面の補正、真空接触の切り替えと真空値の調整、Z軸のゼロ化、露出源の左右移動、アライメント台の上、
シャッターコントローラー:計時制御、:0.1~999.9秒、
エネルギー制御: 0.1~9999.9mJ/cm2(オプション).
性能:
接触露出の場合、I-line光抵抗1umの厚さ、グラフィック解析は1umに達するのが最適です。
近接露光線の幅は5~2umまで最適に設定されます。